近期,寬禁帶半導體國家工程研究中心郝躍院士、馬曉華教授團隊在氮化鎵(GaN)高電子遷移率晶體管(HEMT)領域取得重要突破,成功開發出一種基于低溫磁控濺射氮化鋁(AlN)覆蓋層的新型p-GaN HEMT器件。該成果以“Improved p-GaN/AlGaN/GaN HEMTs with magnetron-sputtered AlN cap layer”為題發表于國際權威期刊《Applied Surface Science》(中科院二區TOP期刊,影響因子6.3),第一作者為博士后賈茂,通訊作者為侯斌副教授、楊凌教授與馬曉華教授。研究通過創新性的AlN界面工程設計,顯著提升了器件的柵極可靠性、動態性能與長期穩定性,為GaN功率器件的商業化應用提供了關鍵技術支撐。

(a)柵極反向電流,(b)柵極正向漏電流隨不同柵極面積的變化,
(c) AlN/p-GaN HEMT在不同溫度下的柵漏特性。(d)濺射AlN/p-GaN二極管的PF圖(log (J)/EAlN vs. 1000E0.5/T)。插圖:從線性提取的PF斜率和截距PF圖擬合。

(a)p-GaN層的XPS價帶和n1s核能級譜;(b)AlN層的XPS價帶和n1s核能級譜,(c)能帶
零柵偏置時AlN/p-GaN hemt的門控區圖和(d)AlN/p-GaN/AlGaN/GaN二極管的電容電壓特性。

(a)脈沖轉移特性測試原理圖,(b)脈沖轉移具有不同靜態偏置的AlN/p-GaN HEMT的特性,(c)脈沖輸出特性測試原理圖和(d)具有不同靜態偏置的AlN/p-GaN HEMT脈沖輸出特性特性。
研究團隊采用低溫磁控濺射工藝在p-GaN柵極表面沉積AlN覆蓋層,通過X射線光電子能譜(XPS)測試證實,AlN與p-GaN界面處形成的1.2 eV價帶偏移能有效抑制柵極漏電流,改善界面質量。與傳統鎢肖特基柵極p-GaN HEMT(W/p-GaN HEMT)相比,新型AlN/p-GaN HEMT展現出以下關鍵性能提升:閾值電壓優化,閾值電壓(Vth)從0.61 V提升至0.82 V,器件開啟特性更穩定;柵極可靠性突破,柵極正向擊穿電壓提升至17 V,工作電壓范圍從7 V擴展至12 V,柵極漏電流降低3個數量級(ID/IG從104優化至107);界面電容-電壓(C-V)遲滯效應顯著減小,表明界面缺陷密度降低;導通電阻(Ron)較傳統器件降低15.3%,有效減少了導通狀態的能量損耗。
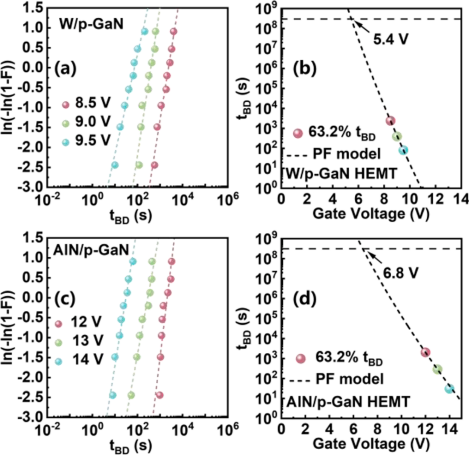
(a)tBD分布的威布爾圖和(b)25℃下W/p GaN HEMTs的壽命預測。(c)tBD分布的威布爾圖和(d)25℃時AlN/p-GaN HEMTs的壽命預預測。
研究團隊進一步揭示了AlN/p-GaN HEMT的柵極泄漏機制,在中壓范圍內,泄漏電流主要由Poole-Frenkel(PF)發射主導。基于此模型推算,器件在室溫下的十年壽命最大正向柵壓(VG)可達6.8 V(失效概率63.2%),較傳統W/p-GaN HEMT(5.4 V)提升26%。此外,AlN覆蓋層通過調控金屬/p-GaN肖特基接觸的耗盡區,維持了GaN溝道的高效耗盡狀態,使關態擊穿電壓進一步提升。
磁控濺射AlN工藝具有低溫生長、成本低廉、工藝兼容性高等優勢,可無縫對接現有GaN器件產線。研究團隊指出,該技術有望加速p-GaN HEMT在高壓快充、新能源汽車電驅系統、數據中心電源等高頻高功率場景的規模化應用。本次研究由國家重點研發計劃、國家自然科學基金等支持,相關技術已申請多項發明專利。
論文信息
Improved p-GaN/AlGaN/GaN HEMTs with magnetron-sputtered AlN cap layer
Jia, Mao; Hou, Bin; Yang, Ling; Xue, Zhiqiang; Xiao, Qian; Zhang, Meng; Lu, Hao; Wu, Mei; Hong, Xitong; Du, Jiale; Chang, Qingyuan; Wang, Xiao; Li, Yang; Ao, Jinping; Ma, Xiaohua; Hao, Yue
Applied Surface Science
DOI:10.1016/j.jmat.2024.100981
原文鏈接:https://www.sciencedirect.com/science/article/abs/pii/S0169433224024152?sessionid=1477088138
(來源:國家工程研究中心)
