氧化鎵(Ga2O3)作為超寬禁帶半導體材料的代表,其具有超寬的禁帶寬度(4.9 eV)和超高的臨界擊穿場強(8 MV/cm),被認為是制備下一代大功率、高效率及低功耗電力電子系統極具希望的半導體材料。此外,經研究發現β-Ga2O3還表現出高達2×107 cm/s的電子飽和速度,其約翰遜優值(2844)較SiC和GaN更高。因此,它在射頻器件領域具有重要的應用潛力,探索研究氧化鎵基射頻功率器件具有重要意義。
p-blur: ; --tw-backdrop-brightness: ; --tw-backdrop-contrast: ; --tw-backdrop-grayscale: ; --tw-backdrop-hue-rotate: ; --tw-backdrop-invert: ; --tw-backdrop-opacity: ; --tw-backdrop-saturate: ; --tw-backdrop-sepia: ; --tw-contain-size: ; --tw-contain-layout: ; --tw-contain-paint: ; --tw-contain-style: ; margin: 0px 0px 1.875rem; padding: 0px; color: rgb(34, 34, 34); font-size: 1.125rem; line-height: 2.25rem; max-width: 100%; min-width: 100%;">然而,在實際射頻應用中,需要考慮控制電路和功耗問題。因此,迫切需要增強型器件來簡化射頻拓撲電路,降低靜態功耗。由于器件設計與工藝方面的不足,目前國際上報道的氧化鎵基增強型MOSFET的性能仍然很差。這些增強型器件在射頻性能方面仍存在諸多不足,最主要的限制因素為器件工藝對溝道電子濃度和溝道遷移率的負面影響。所以,改進器件設計和制備工藝,有效提升溝道遷移率對增強型Ga2O3基射頻 MOSFET非常重要。
p-blur: ; --tw-backdrop-brightness: ; --tw-backdrop-contrast: ; --tw-backdrop-grayscale: ; --tw-backdrop-hue-rotate: ; --tw-backdrop-invert: ; --tw-backdrop-opacity: ; --tw-backdrop-saturate: ; --tw-backdrop-sepia: ; --tw-contain-size: ; --tw-contain-layout: ; --tw-contain-paint: ; --tw-contain-style: ; margin: 0px 0px 1.875rem; padding: 0px; color: rgb(34, 34, 34); font-size: 1.125rem; line-height: 2.25rem; max-width: 100%; min-width: 100%;">西安電子科技大學馬曉華教授研究組創新性地提出了一種準二維高遷移率溝道增強型β-Ga2O3 MOSFET結構。并引入低損傷刻蝕技術形成凹槽柵結構,將重摻雜溝道厚度縮小至幾個納米,減小了垂直方向上的電子散射,有效提高了溝道遷移率。同時使用重摻雜材料作為溝道層,使得器件具有較小的導通電阻和較低的歐姆接觸電阻,從而展現出優異的射頻性能。該研究成果以“Quasi 2D high mobility channel E-mode β-Ga2O3 MOSFET with Johnson FOM of 7.56 THz·V”為題,發表在國際知名期刊《Applied Physics Letters》上。2021級博士研究生王羲琛為本文第一作者,馬曉華教授、陸小力教授、何云龍副教授為論文共同通訊作者。
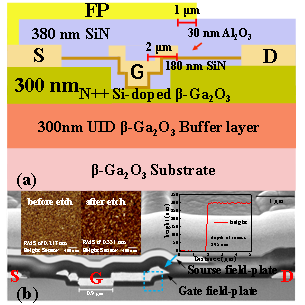
圖1 器件結構示意圖及掃描電鏡圖像
研究表明,器件的制備過程包括在柵下區域進行低損傷刻蝕,刻蝕深度為295 nm。研究組采用分步刻蝕的方法,利用O2等離子體對器件的刻蝕損傷進行修復,氧等離子體在電離過程中產生大量的氧離子,而Ga2O3材料中存在的氧空位可以通過這些氧離子得到補充。AFM圖像顯示刻蝕前后材料表面粗糙度變化量小于0.15 nm,表明了刻蝕過程中引入了較低的損傷,降低了電離雜質散射的影響,從而保證了器件具有較高的遷移率。
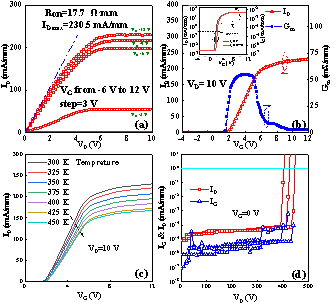
圖2 器件輸出特性、轉移特性、熱穩定性及擊穿特性
通過CV曲線計算得到器件場遷移率為147.5 cm2/(V·s),優異的器件遷移率使其具有良好的射頻特性,器件峰值跨導高達54.2 m S/mm。優異的遷移率是跨導較高的原因之一,這也與器件的轉移特性相吻合。
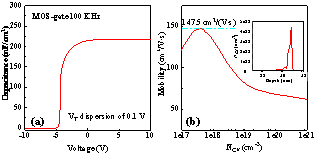
圖3 器件CV曲線及器件遷移率隨載流子濃度變化規律
此外,從仿真結果中也顯示出不同溝道厚度器件的遷移率和射頻特性。溝道厚度較小的器件性能較好,與實驗結果一致,為實驗提供了理論支持。尤其當柵下區域的溝道厚度減小到納米量級時,垂直方向上的電子散射在一定程度上可以忽略,從而實現了類似于2DEG的準二維溝道,有效提高了器件的溝道遷移率,改善了器件的射頻特性。
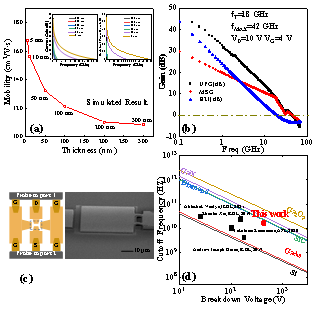
圖4 遷移率仿真結果、器件小信號特性、去嵌結構及約翰遜優值圖
在器件的小信號特性方面,器件的fT和fMAX分別為18 GHz和42 GHz。約翰遜優值 fT×VBK為7.56 THz·V,達到了國際已知的氧化鎵增強型MOSFET器件的最高值。這一結果為β-Ga2O3 基MOSFET在未來射頻功率電子器件中的應用奠定了基礎。
該研究得到國家寬禁帶半導體器件及集成技術重點實驗室開放項目、中央高校基礎研究經費、輻射應用國家創新中心的資助。
來源:寬禁帶半導體教育部重點實驗室
