
摘要:碳化硅( SiC)被認為是最重要的寬禁帶半導體材料之一,具有禁帶寬度大、擊穿電場高、熱導率高、電子飽和速率高、抗輻射能力強等優越性質。基于 SiC 材料制備的半導體器件不僅能在更高的溫度下穩定運行,而且在高電壓、高頻率狀態下也具有更高的可靠性。近 20 年來,隨著材料生長技術、制造工藝與器件物理的迅速發展, SiC 材料及器件在雷達、5G 通信、電動汽車等領域獲得了廣泛應用,對國防工業發展、國家信息安全、國民經濟建設均產生了極其重要的影響。在以 SiC 為基礎的大功率半導體器件產業鏈中,高質量的 SiC 單晶制備及其產業化是最為重要的一環。本文針對半絕緣 SiC 單晶襯底材料國內外發展進行了分析歸納,重點介紹了山東大學半絕緣 SiC 的研究歷程、現狀,并對研究和產業發展、存在的挑戰做了論述。
0 引 言
眾所周知,半導體產業發展至今經歷了三個階段:第一代半導體材料以硅為代表,主要應用在以集成電路( IC)為核心的信息電子領域;第二代半導體材料以砷化鎵等化合物半導體為代表,主要應用在光電子領域、通信領域;第三代半導體材料的興起,則是以氮化鎵(GaN)薄膜材料的 P 型摻雜的突破為起點,以高亮度藍光發光二極管(LED)和藍光激光器(LD)的研制成功為標志。隨著生長技術的發展,第三代半導體材料和應用也越來越廣泛。SiC 材料就是典型的代表之一。
SiC 具有一系列優良的物理化學特性,除了禁帶寬度,還具有高擊穿電場、高飽和電子速度、高熱導率、高電子密度和高遷移率等特點,隨著單晶材料的技術突破,這些性質使得 SiC 成為研究和產業的熱點,有力推動了 SiC 單晶材料的進展。
SiC 單晶作為晶體材料國家重點實驗室最近二十年的重要研究內容之一,在蔣民華院士的主持下,從零起步,高起點布局,采取跨越式發展思路,攻克了一系列關鍵技術難關,培養了大批人才,為我國 SiC 單晶產業及其在核心領域的應用做出了卓越貢獻。本文以 SiC 單晶襯底為主要研究對象,首先簡要介紹其基本性質、研發歷史和制備方法,并結合晶體材料國家重點實驗室的半絕緣 SiC 襯底相關研究工作概述研究、產業現狀和面臨的挑戰,最后對國產 SiC 單晶襯底的發展進行了展望。
1 基本性質、研發歷史
如表 1 所示,SiC 的臨界擊穿電場是 Si 的 10 倍,GaAs 的 5 倍,這提高了 SiC 基器件的耐壓容量、工作頻率和電流密度,降低了器件的導通損耗。加上比 Cu 還高的熱導率,器件使用時無需額外散熱裝置,減小了整機體積。這些均是 SiC 材料的極大優勢。SiC 器件具有極低的導通損耗,而且在超高頻率時,可以維持很好的電氣性能。例如從基于 Si 器件的三電平方案改為基于 SiC 的兩電平方案,效率可以從 96% 提高到97. 6% ,功耗降低可達 40% 。因此 SiC 器件在低功耗、小型化和高頻的應用場景中具有極大的優勢。
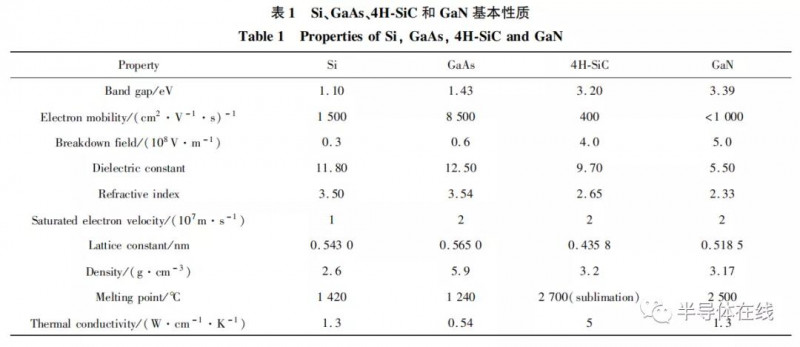
Si 和 SiC 作為半導體材料幾乎同時被提出,但由于 SiC 生長技術的復雜和缺陷、多型現象的存在,其發展曾一度被擱淺。SiC 的發展歷經了多個重要階段,如表 2 所示。第一個階段是結構基本性質和生長技術的探索階段,時間跨度從 1924 年發現 SiC 結構至 1955 年 Lely 法的提出 。第二階段是物理基本性質研究和英寸級別單晶生長的技術積累階段。在此階段物理氣相傳輸( physical vapor transport, 縮寫為 PVT)生長方法基本確定、摻雜半絕緣技術被提出,至 1994 年 Cree 推出了商用的 2 英寸(50. 8 mm) SiC 襯底材料。
從 1994 年以后,隨著國際上半導體照明及 2 英寸 SiC 單晶襯底的突破性進展,掀起了全球 SiC 器件及相關技術的研究熱潮。特別是 SiC 襯底作為核心襯底材料,引起了各國政府的高度重視。早在 2002 年,美國國防高級研究計劃局(DARPA)就啟動和實施了寬禁帶半導體技術計劃(WBGSTI) ,成為加速提升 SiC、GaN 以及 AlN 等寬禁帶半導體特性的重要“催化劑” 。

現階段,SiC 電力電子器件一般在 N 型 SiC 襯底上進行同質外延,制備器件包括肖特基二極管、MOSFET和 IGBT 等。Yole 預測 SiC 功率半導體市場規模的年均復合增速預計將達到38% ,產業界非常看好 SiC 器件市場的發展。
半絕緣 SiC 作為襯底是 GaN 異質外延的優選材料,在微波領域具有重要的應用前景。相比藍寶石14% 、Si 16. 9% 的晶格失配,SiC 與 GaN 材料僅有 3. 4% 的晶格失配,加上 SiC 超高的熱導率,使其制備的高能效 LED 和 GaN 高頻大功率微波器件在雷達、高功率微波設備和 5G 通信系統等方面均有極大的優勢。半絕緣 SiC 襯底研發工作一直是 SiC 單晶襯底研發的重點。
2 研究、產業的現狀和挑戰
2. 1 研究進展與現狀
鑒于 SiC 材料的優異性質,自 2000 年前后國內高校和科研單位開始了 SiC 單晶的襯底研發,山東大學晶體材料國家重點實驗室是國內首批研發單位之一。蔣民華院士根據半導體材料的發展規律和晶體材料國家重點實驗室的使命和初心,提出了發展 SiC 單晶的計劃。在科研經費緊張的情況下,積極籌劃建設經費,親自帶隊,組建了以長江學者特聘教授徐現剛為課題負責人的攻關團隊。
考慮到國內幾乎為零的研發基礎,蔣民華院士在研發初始就制定以下重大決策并逐項落實:
(1)從產業化著眼,高起點地進行研發。為此他抓住“211 工程”二期的大好機遇,重點投入,從國外同時購進兩臺先進的設備,以加快研發速度。
(2)生長和加工并舉。SiC 是硬度僅次于金剛石的晶體,極難加工,因此在生長和優化 SiC 晶體的同時,千方百計解決SiC 切磨拋技術,攻克從單晶到襯底的難關,率先突破了 SiC 超硬材料的化學機械拋光技術,打通了走向應用的關鍵環節。
(3)直接和器件研發單位掛鉤,把材料置于器件研發的應用鏈條中,使器件的性能需求變成優化晶體材料質量的動力,從生長到加工真正達到“開盒即用”的指標,從而極大地促進 SiC 質量的提高。
(4)自主創新研制國產 PVT 單晶設備,為生長裝置國產化和 SiC 單晶的后續發展及產業化打下基礎。
經過二十年的發展, SiC 課題組出色地實施了蔣民華院士的決策和部署,不斷解決生長和加工的關鍵問題,攻克了 2 ~ 6 英寸 SiC 熱場調控、超精密加工、半絕緣電學特性、微管密度、單一晶型等多項關鍵核心技術(具體參見附錄) 。半絕緣 SiC 單晶核心技術的突破培養了一批 SiC 領域的領軍人才,為國產半絕緣技術的發展做出了貢獻,使我國成為目前世界上第三個掌握半絕緣 SiC 襯底材料制備技術的國家,山東大學的 SiC研究歷史就是國內半絕緣 SiC 單晶襯底發展的一個縮影。
限制 SiC 材料應用的主要因素是晶體中高密度微管缺陷的存在,因此 SiC 微管研究一直是前期研發的重點。利用同步輻射、AFM、SEM、計算等手段確認微管是超級螺位錯。SiC 的微管來源有很多,包括多型、異相的物質比如 Si 滴、空洞、生長臺階的交匯以及晶體生長中的應力。圖 1 是山東大學2英寸、3 英寸、4 英寸和 6 英寸微管密度的情況。隨著生長條件優化,其微管密度逐年降低。而圖 2 是原生晶面中心微管形成螺旋生長臺階的 AFM 結果,同時也驗證了微管直徑 D 與其伯格斯矢量 b 的關系(D =μb2/4πγ) [19] 。X 射線同步輻射也是微管觀察的主要手段 。圖 2( b)是山東大學零微管密度襯底全片白光同步輻射形貌結果。對于微管缺陷,2010 年以前研究工作比較多。現階段研發和商用的 SiC 襯底微管密度都得到了有效控制。
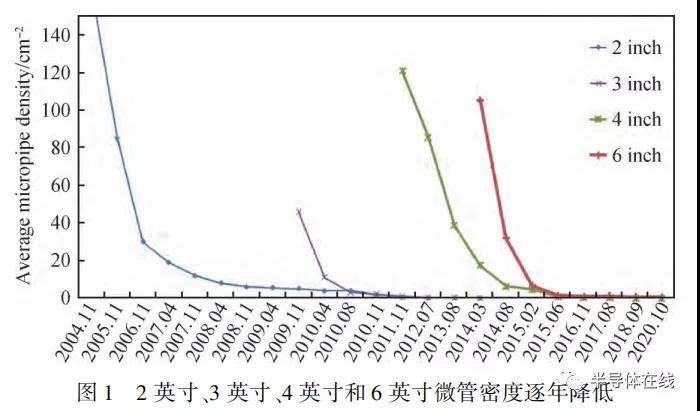
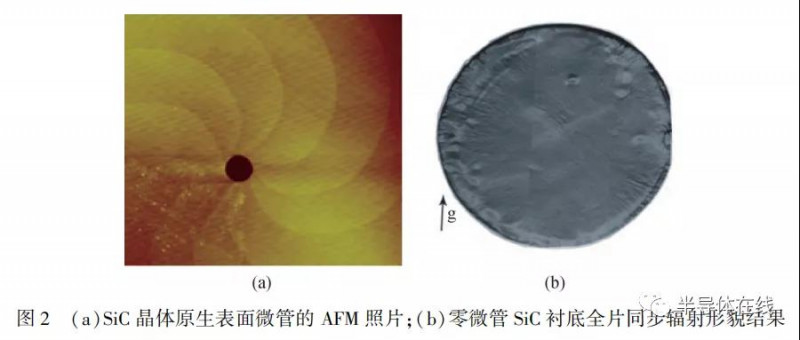
近年來,研究學者將目標轉向降低 SiC 位錯密度的研究。現階段 SiC 襯底中位錯密度的典型值為 103 ~104 / cm2 。高密度的位錯缺陷大幅降低了器件的性能。不同位錯類型對器件性能產生不同的影響。螺位錯(TSD)和刃位錯(TED)會對器件產率產生影響,如降低載流子壽命;而基平面位錯(BPD)對雙極性器件的影響較大,會增加導通電阻和漏電流 。位錯的表征手段有很多,其中同步輻射白光形貌術、透射電子顯微鏡(TEM)是通用的觀察方法,但制樣相對困難。KOH 熔融腐蝕結合顯微鏡觀察是目前常用的方法,這種方法制樣簡單、方便快捷,根據腐蝕坑的形貌、尺寸、截面等信息可辨出不同的位錯類型,且可實現全片的觀察 。而采用PL 等光學方式可以全面分析缺陷、劃痕、顆粒等 。山東大學在半絕緣SiC 襯底腐蝕坑表征和辨別、刃位錯線形成小角度晶界機制、氫氣對缺陷密度影響和選擇區域側向外延生長降低缺陷等方面開展了大量工作。圖 3 是山東大學 SiC 襯底全片腐蝕照片,其 TSD 密度為 390 / cm2 ,BPD密度為 221 / cm2 。
具有不同電學特性的 SiC 襯底研制一直是 SiC 單晶研究中的重要工作。現階段 SiC 襯底主要有兩類。第一類是 N 型導電的 SiC 襯底,其電阻率小于30 mΩ·cm,主要用于同質SiC 薄膜外延制備電力電子器件。第二類是半絕緣 SiC 襯底,電阻率大于 105Ω·cm,用于異質生長GaN 薄膜制備射頻器件。其中半絕緣 SiC襯底材料一直是研發的重點,也是難點。 生長半絕緣SiC材料的主要難度之一就是如何降低晶體中由石墨坩堝、保溫吸附和粉料中摻雜引入的 N 施主雜質。第二個主要難點就是在保證晶體質量和電學性質的同時,引入深能級中心補償殘存的具有電學活性的淺能級雜質。其中引入過渡金屬 V 作為深能級雜質制備的 SiC 襯底材料被稱為摻雜半絕緣。2007 年,山東大學寧麗娜等首次報道了半絕緣6H-SiC單晶的生長工作 ,采用 V 摻雜技術獲得電阻率高于1010Ω·cm的襯底材料。SIMS 測試顯示其晶體中V 的含量處于同一數量級(5. 2 × 1016 ~ 1. 1 × 1016 cm -3 ) ,顯示了較高縱向摻雜均勻性。2016 年山東大學彭燕等報道了高質量半絕緣 6 英寸 4H-SiC 生長研究工作,利用數值模擬獲得高均勻、高質量的半絕緣 6 英寸 SiC 襯底材料 。拉曼光譜 Mapping 測量顯示 6 英寸 SiC 襯底全片無多型,均為4H-SiC晶型。X射線搖擺曲線顯示半寬小于 30 ″。采用摻雜過渡金屬 V 雜質,獲得了電阻率超過 5 × 109 Ω·cm 的SiC襯底。
利用本征點缺陷作為深能級中心補償淺能級雜質稱為高純半絕緣。由于高純半絕緣 SiC 襯底需要將背景淺能級雜質控制在 10 16 cm - 3數量級,其制備難度相對更高。2010 年以前只有 Cree 可提供 PVT 法制備的高純半絕緣襯底材料。山東大學在摻雜半絕緣研究的基礎上,首要解決的是高純粉料的合成工作,采用二次合成法在保證合成產率的基礎上,提高合成粉料的純度。并于2014 年首次在國內報道高純半絕緣SiC襯底制備工作, 并以此為基礎制備 AlGaN / GaN 異質結 HEMT 器件, 其室溫二維電子氣遷移率達到2053 cm2 / (V·s)。圖 4 為山東大學 6 英寸高純半絕緣 SiC 襯底的電阻率分布圖。

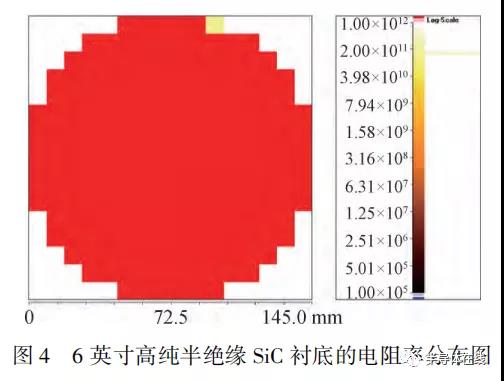
P 型的 SiC 是制備高功率電力電子器件的理想襯底,但電阻率很難降低,其 P 型摻雜技術仍在研究階段。由于 P 型摻雜的難點,如受主電離能高導致襯底電阻率高;缺少合適的氣體摻雜源,導致摻雜不均勻;受主元素蒸汽壓高導致晶體中產生大量缺陷等使得生長 P 型體塊 SiC相對困難 。在高壓領域中,采用理論模擬表明:N 溝道 SiC IGBT 在性能上遠遠優于 P 溝道 SiC IGBT。現階段 N 溝道 IGBT 制備因為欠缺 P 型 SiC 襯底材料,制備過程相對繁瑣,增加了 N 溝道 IGBT 器件的制備難度。因此,高質量低電阻率的 P型 SiC 襯底對 N 溝道 IGBT 器件的研制具有重大的應用價值。山東大學采用 B-Al 共摻獲得了高質量 4 英寸低電阻率的 P 型樣品,其全片電阻率均低于 0. 258 Ω·cm,結果如圖 5 所示。X 射線搖擺曲線結果顯示其半寬僅為 43. 6″。
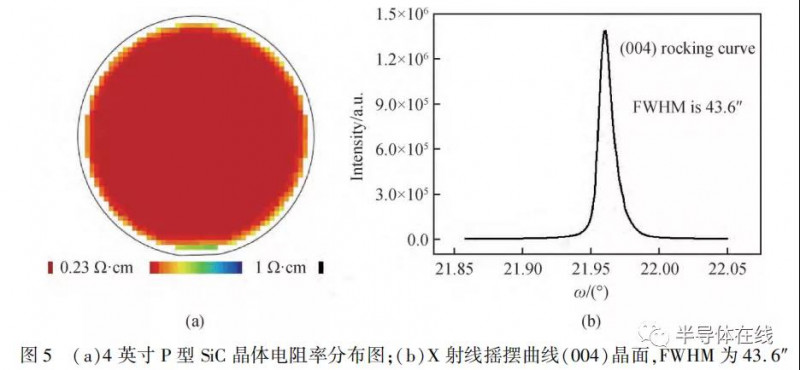
隨著單晶直徑的擴大,特別是 6 英寸(150. 00 mm)和 8 英寸(200. 00 mm)晶體的研發,較大的徑向溫度梯度會引入位錯等缺陷,嚴重情況下甚至出現開裂等問題。山東大學的謝雪健等利用中子衍射方法定性分析了晶體中的應力情況,中子衍射測量示意圖如圖 6 所示,生長初期在小邊區域晶體存在較大壓應變,而在小邊對面區域存在較小的張應變,應變大小在- 2. 230 × 10- 3 ~ 4. 633 × 10 - 4之間(見圖 7( b) ) 。生長后期晶體(0004)晶面的應變在 - 2. 685 × 10- 3 ~ 3. 317 × 10- 4之間(見圖 7( d) ) 。生長初期、后期晶體 < 0001 > 方向的應力大小基本一致,大小在 - 1 445 ~ 178 MPa,應力沿 < 11 - 20 > 方向。同時也說明晶體中 < 0001 > 方向的應力具有繼承性 。

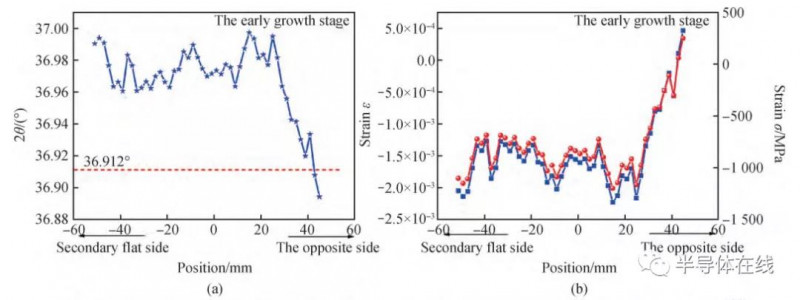
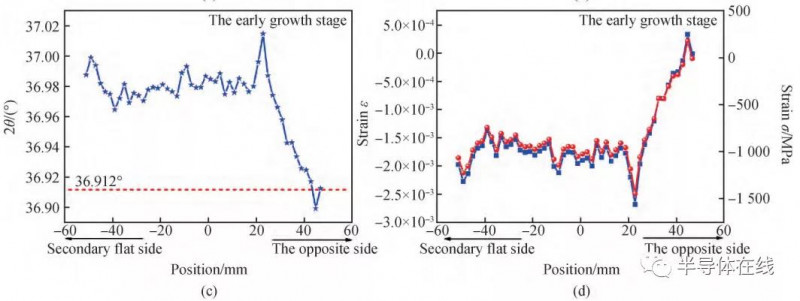
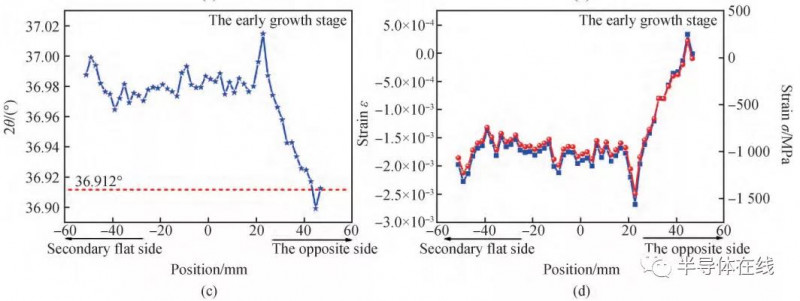
2. 2 挑戰與產業現狀
器件的飛速發展和應用的擴展,給 SiC 單晶帶來諸多挑戰。一是成本問題,SiC 襯底的價格仍遠遠高于Si、藍寶石等襯底。降低成本需要更加成熟的生長和加工技術,一方面提高襯底材料的成品率,另一方面是通過擴徑研究增大面積,降低單個器件成本。2015 年國際廠商 Cree 等推出了 200 mm 的 SiC 襯底樣品,并積極擴大產能,與英飛凌、意法半導體、安森美等國際半導體廠商簽訂長期的 6 英寸 SiC 襯底供貨協議,為光伏逆變器、電動汽車等高增長市場提供材料支撐。2019 年,II-VI 簽署了一項總金額超過 1 億美元的多年協議,為部署在 5G 無線基站的氮化鎵射頻功率放大器提供碳化硅襯底。
其次就是單晶質量方面的問題。SiC 單晶襯底的位錯密度仍高達 103 / cm2 以上,其面型參數如 Warp 等也難以控制 。因此如何控制相關參數,減低缺陷密度、控制面型是 6 英寸和 8 英寸襯底質量優化的主要工作。2017 年 II-VI 公司在 Silicon carbide and related material會議上報道了 200 mm襯底位錯密度控制的相關工作,其位錯總數已經實現了 2. 8 × 103 / cm2 。然而如何控制位錯密度鮮有報道。
最后一個技術挑戰是包括新的生長方法、溫場設計、摻雜和加工等技術探索。現階段如高溫化學氣相沉積法(HTCVD) 、液相生長技術仍在研發階段,需要進一步的關注 。HTCVD 法的特點是不受粉料的限制,以高純氣體作為原料,適合半絕緣單晶的制備。隨著技術發展,其位錯密度也逐步降低至103 / cm2 ,生長速率從最初的微米量級提高到毫米量級。但是相比PVT,其成本仍然較高。
日本相關單位一直致力于液相法。液相法的優點是近平衡生長,可以獲得低缺陷密度襯底。難度是 Si溶液中的 C 溶解度極低,很難形成化學計量比的溶體,這就導致單晶生長速率極低。因此考慮加入金屬催化劑如 Ge、Al、Cr、Ti、Fe 等增加碳的溶解度,其中 Fe 基的Fe-Si合金速率可實現200 μm / h 的生長 。現階段液相生長可以實現擴徑生長,直徑最大到 4 英寸。同時,在籽晶缺陷密度很大的情況下,生長的晶體缺陷密度也僅有籽晶的十分之一,有助于實現零螺位錯、刃位錯的襯底生長。
3 結語與展望
縱觀半導體 70 多年的發展歷史,技術的不斷進步與更新是其特色。SiC 材料也是這樣,一方面單晶尺寸不斷增大,另一方面材料生長工藝持續改進,質量不斷提升。
現階段,國產 SiC 襯底技術和產業均有了長足進步。但從國際市場看,其占有率較低。SiC 襯底生長工藝和產品從直徑、缺陷密度、穩定性等參數上與國際主流商用單位 Cree 等的同類產品還有一定差距。這是挑戰也是機遇。
基于 SiC 單晶生長飽和蒸汽壓大、組分偏移、多晶共生等固有物性,如何滿足未來外延和器件應用的不同需求,解決大尺寸、高質量、高性能單晶氣相生長等科學問題,繼續開展 SiC 單晶生長與加工的基礎和應用研究,逐步突破核心技術,顯得異常必要和迫切。
