第三代半導體氮化鎵(GaN)材料具有禁帶寬度大、電子飽和速度及電子遷移率高、擊穿場強高等特性[1],使 GaN HEMT 器 件 擁 有 高 頻 率、高功率、耐高溫高壓、抗輻射等優點,在 射 頻 領 域 有 廣 闊 的 應 用 前 景,得到了美國 Cree等半導 體 巨 頭 公 司 的 關 注[2-4],國內也有北 大、西 電[5]以 及 中 國 電 科 等 單 位 進 行 長 期 的研究。
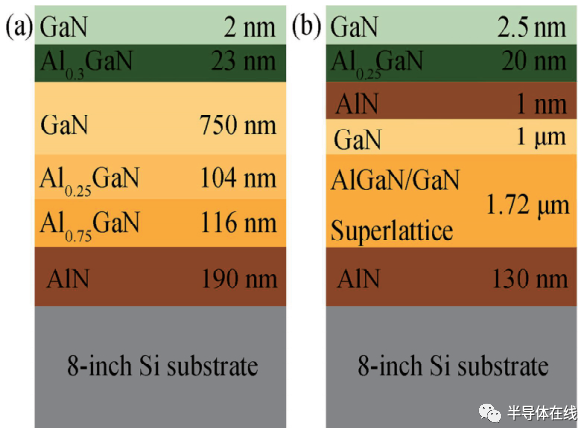
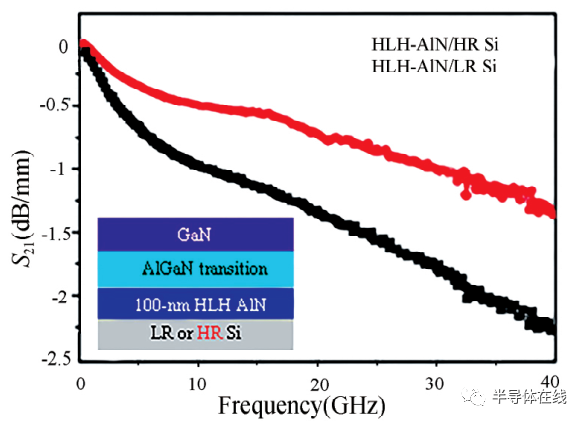
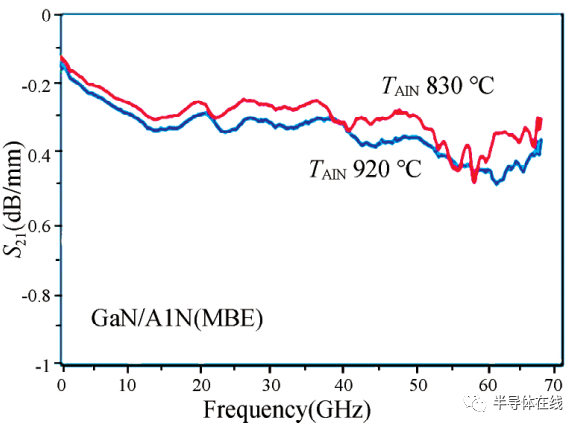
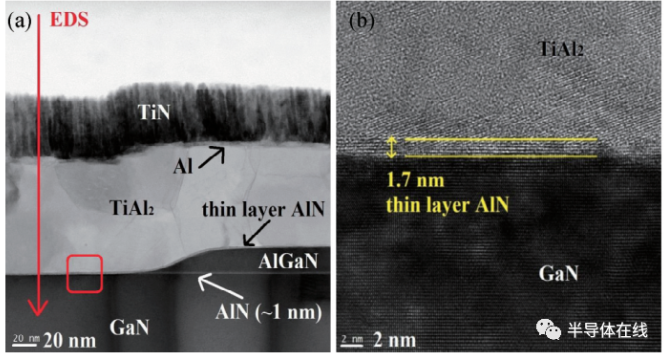

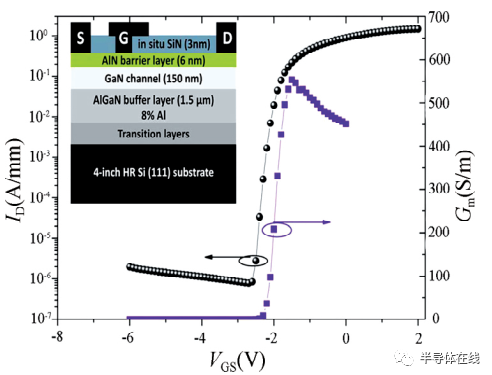
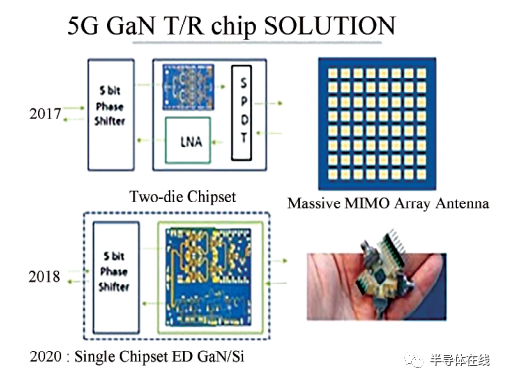
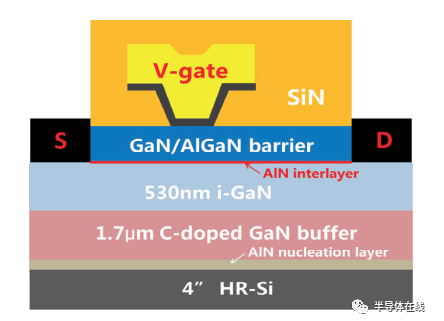
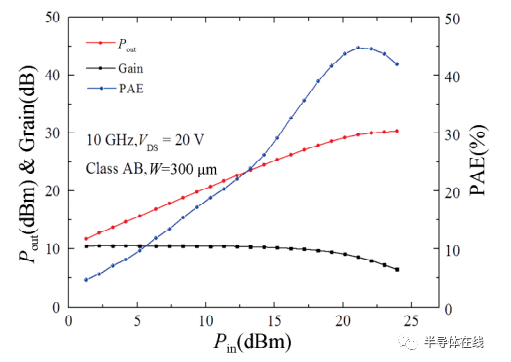

碳化硅(SiC)材 料 的 熱 導 率 高,晶 格 匹 配 性 優 異,由其外延 得 到 的 GaN 薄 膜 結 晶 質 量 是 最 優 的,然 而SiC襯底的價格高昂,晶圓 尺 寸 小(3~4 英 寸 為 主),不利于 GaN 射頻器件的產業化。硅(Si)材料的價格低廉、晶圓尺寸大(≥6英寸)、熱導率良好,若能解決SiCMOS工藝與 GaN 制備工藝的兼容問題,即可低成本、大規模地生產 GaN 射頻器件,進而推動5G 通信及其他新興技術的普及應用。此外,除 了 傳 統 的 單 一射頻芯片 或 功 率 器 件 外,還 可 利 用 Si工 藝 平 臺 實 現GaN 射頻器件與功率器件的單片集成,以及與Si器件的異質異構集成等,大幅提升電路 性 能 與 集 成 密 度,推動智能前端芯片技術發展。因此 Si基 GaN 技術正受到國內外科研院所與產業界越來越多的關注 [6-8]。
本文主要調研了 近 年 來 國 內 外 關 于 Si基 GaN 射頻器件在材料、工 藝 與 電 路 上 的 研 究 進 展,剖析了相關技術難點與存在問題,并展望了 Si基 GaN 射頻器件未來的優化發展方向。此 外 還 基 于 射 頻 損 耗 較 低 的高阻 Si上 AlGaN/GaN HEMT 材 料,報 道 了 研 制 的0.25μm 及0.4μm 工藝下的Si基 GaN 射頻器件,經測試在 C波段及 X 波段下工作性能優異,揭示了Si基GaN 射頻器件在5G 應 用 及 低 成 本 雷 達 等 領 域 的 獨 特優勢和應用前景。
1.國內外研究現狀
自20世紀90年代初,Khan等[9]在藍寶石襯底上率 先 制 得 了 AlGaN/GaN 結 構, 隨 后 AlGaN/GaN HEMT 的 直 流 及 微 波 特 性 相 繼 被 報 道[10-11], 關 于GaN HEMT器件的研究逐漸成為熱點。由于 GaN 單晶難以制備,GaN HEMT器件一般由異質外延生長得到,所使用 的 襯 底 材 料 有 SiC、藍寶 石、Si三 種。半絕緣SiC材料由于 具 備 良 好 的 晶 格 匹 配 性 和 優 良 的 熱導率,一直是 GaN HEMT 外 延 襯 底 的 最 佳 選 擇。然而,SiC作為襯底存 在 著 晶 圓 尺 寸 小、成本過高的問題,嚴重限制了 GaN 器件的推廣應用。而對于藍寶石襯底,其晶圓尺寸 較 大 且 價 格 較 為 便 宜,但其硬度太高、熱導率極低且晶格失配大,不 利 于 后 續 加 工 與 應用。相較之下,Si襯底上 GaN 技術不僅具有較好的熱導率和最低的襯底成本,而 且 晶 圓 尺 寸 大,起點6英寸且易升級到8英寸以上,并可與Si工藝線兼容,具有顯著的成本優勢和 規 模 化 生 產 能 力。下面將介紹近年來國內外關于Si基 GaN 射頻器件的研究進展。
1.1Si基 GaN 射頻材料優化生長
Si與 GaN 之間存在的較大晶格失配和熱失配是制約Si基 GaN 技 術 發 展 的 主 要瓶頸,由 失 配 產 生 的 位錯與應力會嚴重 影 響 結 晶 質 量,并 惡 化 器 件 性 能。因此如何消除各外延 層 之 間 的 應 力,探 究 出 有 效 的 應 力調控技術,是改善 Si基 GaN 射 頻 器 件 各 項 特 性 的 基礎。此外,與電力電子器件不同,Si基 GaN 射頻器件由于高阻Si晶圓難以制備,且襯 底 與 成 核 層 界 面 處 易形成導電層,導致器 件 在 高 頻 工 作 狀 態 下 存 在 射 頻 損耗,限制輸出功率和效率。因此,如 何 優 化 襯 底 及外延結構,抑制射頻損耗,是實現 Si基 GaN 射頻器件大規模高效應用的關鍵。
2019年,Tzeng等[12]在8英寸Si襯底上分別制備了 Al組分漸變 AlGaN 緩沖層和 AlGaN/GaN 超晶格緩沖層 兩 種 結 構 的 GaN HEMT 器 件,如 圖 1 所 示。經 TEM、XRD、拉 曼 光 譜、AFM、EPD、直 流 特 性以及頻率特性等系統地測試 分 析 比 較 兩 種 結 構 對 器 件各項性能指標的影響,發現采用 AlGaN/GaN 超晶格緩沖層結構的器件無論是結 晶 質 量 還 是 直 流 特 性 或 頻率特性均展現出更優的測試結果,在0.17 μm 柵長下測得fT和fmax分別達到41.6GHz和126.46GHz。同年 Yang等[13]設計了Si摻雜的 AlGaN 背勢壘層以及 C摻雜的 GaN 緩沖層得到了漏電小、耐擊穿且電流崩塌效 應 低 的 Si基 AlGaN/GaN HEMT 器 件。2020 年,Xia等[14]分 析 了 GaN 和 SiN 兩 種 不 同 帽 層 結 構 對AlN/GaN HEMT器 件 性 能 退 化 的 抑 制 效 果,發 現 帶有3.5nm 原位鈍化SiN 帽層以及4.5nm AlN 勢壘層結構的Si基 GaN HEMT 器 件 具 有 最 低 的 薄 層 電 阻、最 高 的 二 維 電 子 氣 濃 度 (Two-DimensionalElectron GasDensity)以及最好的穩定性。
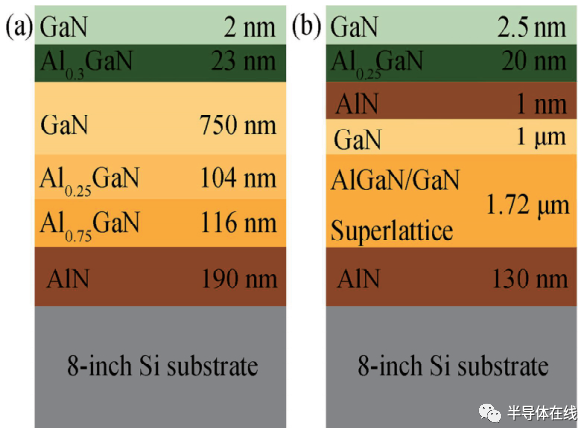
圖1 采用組分漸變 AlGaN 的緩沖層結構(a)和 AlGaN/GaN超晶格的緩沖層結構(b)[12]
2017年,Luong等[15]采 用 HLH Temperature的生長模式在高阻Si襯底(104 Ω·cm)上外延出100nm的 AlN 緩 沖 層,得 到 的 GaN HEMT 有 效 抑 制 了 因AlN/Si之間晶格失配所產生的張應力,從而降低極化電場強度,減小射頻損耗。通過對長度為1 mm 的共面波導(CPW)測 試,10 GHz下 射 頻 損 耗 僅 0.4dB/mm,40GHz下的射頻損耗低于1.2dB/mm,材料結構及測試結果如 圖 2 所 示。同 年,Cordier等[16]采 用NH3-MBE技術,在高阻Si襯底(104 Ω·cm)上生長了0.2μm 的 AlN 成核層和0.5 μm 的 GaN 緩沖層,此生長模式相較于 MOCVD 更易控制 AlN/Si間的界面態,且其低溫生長特性 能 在 抑 制 界 面 態 漏 電 的 同 時 保證高結晶質量。經測試35GHz下的射頻損耗低于0.3dB/mm,且70GHz下的射頻 損 耗 低 于0.5dB/mm,并對比了不同 AlN 生長溫度 對 射 頻 損 耗 的 影 響,如圖3所示。此外,Chiu等[17]利用絕緣襯底上硅(SOI)制備 了 AlGaN/GaN MISHEMT, 采 用 SOI 襯 底 的HEMT器件具有低寄生電容、低射頻損耗、高襯底絕緣度等適用于射頻器件的優點,經測試0.25 μm 柵長下fT和fmax分別達32.1GHz和51.9GHz。
可以看出合理的帽層、勢 壘 層 以 及 緩 沖 層 等 結 構設計不但能夠調控應 力 提 高 結 晶 質 量,還能使器件具備優異的直流特性和頻率特性,與 此 同 時 要 優 化 襯 底及成核層結 構 以 求 降 低 射 頻 損 耗,一 方 面 可 以 提 高AlN 的結晶質量并抑制 AlN/Si間的界面態,另一方面應從緩 沖 層 及 Si襯 底 入 手,提 高 器 件 絕 緣 度,減 小漏電。
圖片
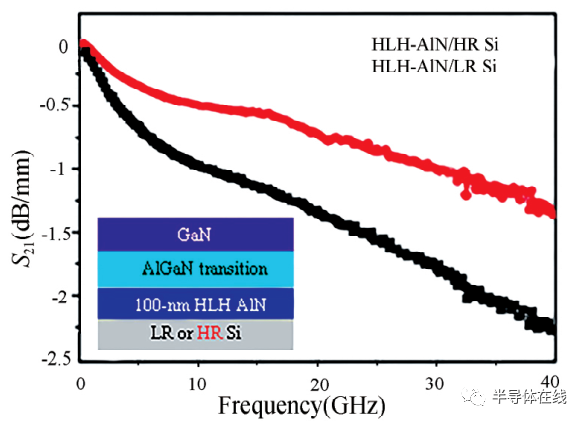
圖2 高低阻Si襯底上外延100nm HLH AlN 的射頻損耗[15]
1.2 無金的Si基 GaN 工藝技術
現有的Si基 射 頻 GaN 器 件 制 造 工 藝 幾 乎 都 是 基于有金(Au)工藝 完 成 的。Au是 傳 統 GaN 器 件 歐 姆 接觸工藝中的必 備 金 屬 之 一,采 用 Ti/Al/X/Au(X 可 為Ti、Ni、Mo、Pt等)結 構 合 金 的 接 觸 電 阻 可 達 到0.3Ω·mm 左 右,且 性 能 穩 定。然 而,含 Au的 GaN 制備工藝存在著成本高以及與傳統 CMOS工 藝 不 兼 容 等問題,提高了 Si基 GaN 射 頻 器 件 的 生 產 成 本。實 現無 Au工藝的關鍵是做到源漏金屬的無 Au化,對此已有 Ti/Al/TiN、Ti/Al/Ti/TiN、Ti/Al/W、Ti/Al/Ti/TiW、Ti/Al/Ni/Pt、Ti/Al/NiV 等 方 案 提 出,所 獲 得的歐姆接觸電阻 一 般 在0.5~1.0Ω·mm,盡 管 這 些方案能夠 一 定 程 度 地 滿 足 電 力 電 子 功 率 器 件 的 需 求,然而面對射頻器件對 寄 生 電 阻 的 嚴 格 要 求 仍 存 在 較 大的差距。
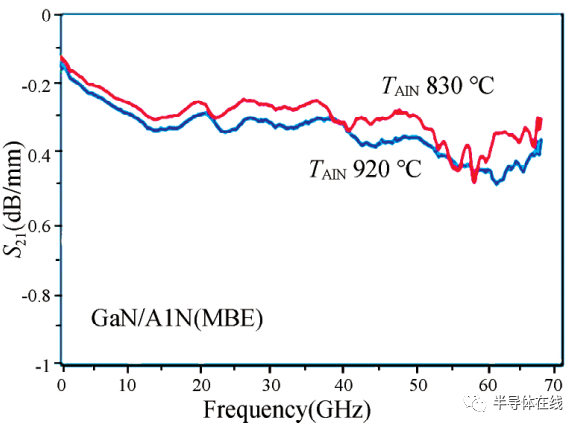
圖3 不同溫度下采用 NH3-MBE技術生長 GaN/AlN緩沖層的射頻損耗對比[16]
2017年,Ferreyra等[18]采 用 脈 沖 激 光 燒 蝕 技 術(PLD),在Si襯 底 上 制 備 了 表 面 光 滑 且 形 貌 良 好 的n+ -GaN,并在 其 上 淀 積 Hf/Al/Ti(20/200/20nm)形成無 Au歐姆接觸,此外 Hf金屬的功函數(3.5eV)低于 Ti(4.1eV)與 TiN(4.7eV),故 更 適 合 作 為 歐 姆 接觸的 電 極,經 測 試 得 到 接 觸 電 阻 為0.17Ω·mm,比接觸 電 阻 可 達 10-7 Ω·cm2 量 級。2018 年,Zhang等[19]在Si襯 底 上 經 勢 壘 層 刻 槽 處 理 后,采 用 Ti/Al/Ti/TiN (2.5/100/20/60nm)的 無 Au歐 姆 接 觸 工 藝 制備了 AlGaN/GaN HEMT 器 件,退 火 后 的 結 構 如 圖4所示。其中底 層 金 屬 Ti的 厚 度 僅 為2.5nm,既 能 夠形成厚度適宜 的 TiN 層 讓 Al與 TiN 發 生 固 相 反 應 生成 AlN,又不會因 Ti太厚而阻止兩者反應,使接觸電阻大大降低,在550 ℃下 合 金 得 到 的 接 觸 電 阻 與 比 接觸電阻分別為0.21Ω·mm 和1.16×10-6 Ω·cm2。
可見采 用 二 次 外 延 高 質 量 n+ -GaN、勢 壘 層 刻 槽以及無 Au歐 姆 接 觸 等 技 術,能 夠 得 到 較 低 的 接 觸 電阻和比接觸 電 阻 并 改 善 表 面 形 貌。此 外 無 Au的 歐 姆接觸工藝也為實現無 Au的Si基 GaN 技術,降低生產成本提供了保障。
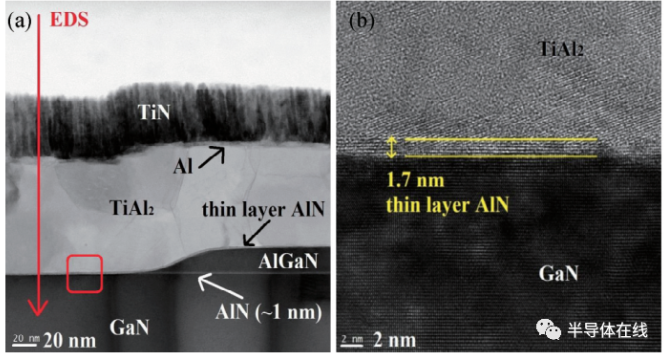
(a)合金退火后金屬結構;(b)合金與半導體接觸面結構
圖4 Ti/Al/Ti/TiN 在550 ℃退火后的 HR-TEM 圖[19]
1.3 復合鈍化的Si基 GaN 工藝技術
為了 解 決 Si基 GaN 射 頻 器 件 的 電 流 崩 塌 問 題,一般需要在器件表面淀積 SiN 鈍化保護層,其能夠有效抑制表面態對電子的俘獲效應,從而抑制電流崩塌,但是與此同時溝道的 電 子 濃 度 也 會 提 高,短溝道效應也隨之加劇,惡 化 輸 出 特 性 和 關 斷 特 性。此外SiN 鈍化層通常由PECVD 低溫生長得到,此工藝會導致SiN薄膜中 H 離子雜質過多且致密性較差,鈍化效果不理想。并且由于Si襯底的絕緣度遠不如SiC 襯底,漏電問題也嚴重制約著 Si基 GaN 射 頻 器 件 的 性 能。因此探究高水平的先進鈍化工藝是 有 效 抑 制 電 流 崩 塌 和 表面漏電的關鍵技術方案。LPCVD 不同于 PECVD,是一種高溫鈍化SiN 的工藝,通 常 在 器 件 工 藝 開 始 前 完成,生長得到 的 鈍 化 層 致 密 性 好、質量高。原位鈍化MOCVD 是一種在 GaN 生長結束后繼續生長SiN 保護層的方法,能夠有效避 免 器 件 表 面 受 到 外 界 環 境 的 污染,故鈍化效果良好。
2019年,Zhang等[20]采 用 LPCVD 技 術 在 GaN表面生長了一層20nm 的 SiN 鈍化層,經 CV 測試分析發現由 LPCVD 生 長 的 鈍 化 層 相 較 于 PECVD 具備更好的致 密 性,并 且 能 夠 有 效 抑 制 表 面 漏 電。2020年,Chen等[21]采用原位鈍化 MOCVD 技術在勢壘層上生長了3nm 的SiN 作為柵介質,制得0.7μm 柵長的 AlGaN/GaN MISHEMT 器件性能良好,電路開關比達106,電流退化率為18%,測得fT和fmax分別為12.5GHz和15GHz。為了比較 PECVD、LPCVD 復合鈍化以及原位鈍化 MOCVD 對電流崩塌以及表面漏電的抑制作用,Huang等[22]用 上 述 三 種 不 同 的 方 式 在同種器件結構上制備了三種SiN 鈍化層,鈍化效果對比 如 圖 5 所 示, 可 以 看 出 LPCVD 復 合 鈍 化 層(Bilayer)的曲線波動是最小的,說 明 該 種 鈍 化 方 式 對電流崩塌和表面漏電的抑制效果最好。
為在 抑 制 電 流 崩 塌 的 同 時 減 小 漏 電, 并 改 善PECVD 鈍化帶來的致密性差、H 離 子 雜 質 多 等 問題,可采用原位鈍化 MOCVD 以及 LPCVD 生長高質量的鈍化層。然而致密 性 過 高 的 鈍 化 層 難 以 刻 蝕,會影響后續器件工藝開展,對 此 可 采 用 復 合 鈍 化 的 辦 法,在一層較薄的原位鈍化 MOCVDSiN 或 LPCVDSiN 上通過PECVD 繼續生長SiN,最終形成的高質量復合鈍化層既有很好的保護作用又便于后續器件工藝的進行。

(a)電流響應;(b)陷阱時間常數
圖5 三種鈍化層的效果對比[22]
1.4 Si基 GaN 射頻器件與電路設計
伴隨著材料結構設計和器件制備工藝的持續改進,Si基 GaN 射頻器件及其電路的性能也不斷刷新著行業記錄。
在微波毫 米 波 頻 率 特 性 方 面,早 在 2004 年 法 國GaN 研究中心(IEMN)的 Minko等[23]率 先 在 電 阻 率 為20kΩ·cm 的高阻Si襯底上制備了柵長為170nm,且AlGaN 勢壘層厚度為30nm 的 GaN HEMT射頻器件,當源漏電 壓 為 10 V,柵 電 壓 為 1 V 時,輸 出 電 流 為0.55A/mm,fT和fmax分別為46GHz和92GHz;并在2013年 Bouzid等[24]將 AlGaN 勢壘層的厚度降低到12.5nm,柵長縮短到90nm,當源漏電壓為5V,柵電壓為 -2.1 V 時, 測 得 fT 和 fmax 分 別 提 高 到 100GHz 和 206 GHz。2009 年, 瑞 士 聯 邦 理 工 學 院(EPFL)與 蘇 黎 世 聯 邦 理 工 學 院(ETH)合作[25],采用17.5nm Al0.26Ga0.74N 勢壘層,柵長為100nm,源漏電壓為2.5V,柵電壓為-2V 時,輸出電流為0.75A/mm,fT和fmax分別為101GHz和128GHz;2015年 Marti等[26]采 用 3.5nm 厚 的 AlInN 作 為 勢 壘 層,制備了柵長為50nm 的 AlInN/GaN HEMT 器件,源漏電壓5V,柵電壓2V 時,輸出電流為1.6A/mm,fT和fmax分別提升至141GHz和232GHz。新加坡南洋理工大學(NTU)在大尺寸硅基 GaN 材料外延與器件制備方面也進 行 了 大 量 的 研 究,2012年 Ng等[27]基于8英寸Si晶圓制備了柵長為0.3μm 的Si基 GaN 射頻器件,源漏電壓為10V,柵電壓為-2V 時,測試得到fT和fmax分別為28GHz和64GHz;接著在2014年 Ranjan等[28]又 報 道 了 基 于 高 阻 Si襯 底 的 T 型 柵AlGaN/GaNHEMT器件,其采用了厚度僅為8nm 的AlGaN 勢壘層,柵長為0.15 μm,經測試fT和fmax分別達 到 了 63 GHz和 128 GHz,擊 穿 電 壓 為 132 V,Johnson品質因子高達8.32THz·V。此外,在2018年他們還與 MIT 合作[29]報道了40nm 柵長的I型 柵InAlN/GaN HEMT器件,測得fT和fmax分別達到250GHz和60GHz。同年,南京電子 器 件 研 究 所 與 蘇 州納米所合作[30]報道了55nm 柵長的 T 型柵 AlGa(In)N/AlN/GaNHEMT器件,經測試fT和fmax分別為145GHz和220GHz,可與國外先進研究成果相媲美。
在微波功率方面,日本 OKI公司的Shinichi等[31]在2009年就有相關研究成果報道,在源漏電壓為70V,工作頻率為2.14GHz時,測試高阻Si基 GaN 射頻器件功率 特 性,得 到 輸 出 功 率 密 度 (Pout)達 12.88W/mm,最大功率附加效率(PAE)達64%,測試結果表明Si基 GaN 在射頻應 用 方 面 存 在 巨 大 潛 力;同年,瑞士聯邦理工學院的 Sun等[25]基于9nm 厚的 AlInN勢壘層,研制了柵長為100nm 的Si基 GaN HEMT器件,在源漏電壓為15V,工作頻率為10GHz時測得Pout為 2.5 W/mm,PAE 達 23%;2012 年,Chang等[32]采用斜場板結構研制的Si基 AlGaN/GaN 器件在8GHz下 Pout達到了5 W/mm;2014年,日本瑞薩電子的 Yasuhiro等[33]制備了柵長為0.16 μm 的 T 型柵AlGaN/GaN HEMT器件,源漏電壓為30V,工作頻率為14GHz時,Pout為3.82 W/mm;同 年,首 爾 大學的 Lee等[34]報道了研制的Si基 AlGaN/GaN HEMT器件在 8 GHz下 的 功 率 性 能,脈 沖 輸 出 功 率 達 8.1W/mm(脈寬為100μm,占空比為10%),功率增益為8dB,PAE達39%,總功率接近30 W。
在 毫 米 波 功 率 方 面, 法 國 IEMN 的 Medjdoub等[35]于2012年 在 4 英 寸 高 阻 Si襯 底 上 制 備 了 AlN/GaN HEMT器件并展示了首個40GHz頻率下的功率測試結果,得 到 Pout為 2.5 W/mm,器 件 結 構 及 ID-VGS曲線如圖6所示;2013年 Medjdoub 等[36]又將 40GHz下 的 Pout提 高 到 3.2 W/mm;2015 年 ETH 的Marti等[26]報道了國際上首個 W 波段 Si基 GaN 射頻器件,工作頻率為94GHz時,Pout達1.35 W/mm。
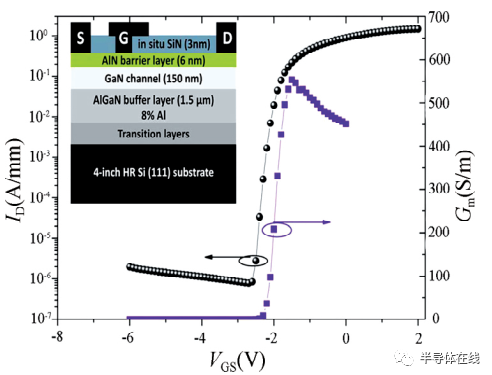
圖6 IEMN 制備的毫米波器件結構及其ID -VGS曲線[35]
在產品方面,近年來在5G 通 信 技 術 和 先 進 低 成本相 控 陣 雷 達 得 到 越 來 越 廣 泛 應 用 的 大 背 景 下,OMMIC、MACOM、IMEC 以 及 MIT 等 海 外 巨 頭 公司和機構紛紛加大投入,在器件性能、成本和技術等方面展現出 卓 越 的 市 場 競 爭 實 力,其 中 代 表 公 司 有MACOM 和 OMMIC。
MACOM 公司自2014年起著力研究 Si基 GaN 技術,并逐漸將重心從SiC基 GaN 芯片轉移過來,截至目前已經開發了多代Si基 GaN 射頻器件,向通信、軍事以及其他應用領域的客 戶 提 供 了 上 百 萬 件 基 于Si基GaN技術的產品。采用標準的0.5μm HEMT工藝制程制備的分立 及 集 成 放 大 器,能夠在直流到6GHz的超寬頻帶范圍內工作,同時產品的增益、增益平坦度、效率以及 穩 定 性 均 處 于 行 業 領 先 水 平,如 NPTB00004A
型寬帶 GaN晶體管在28V工作電壓以及2.5GHz頻率下的線 性 增 益 達 14.8dB,Pout為 5 W,且 PAE 超 過55%,憑借其超 寬 的 工 作 頻 率 范 圍 可 應 用 于 L/C波段雷達、無線通信 以 及 航 空 航 天 等 領 域。此外 MACOM公司還于2018年宣布了與意法半導體(ST)的合作計劃,由ST協助 MACOM 生產晶圓,顯著提升了Si基 GaN射頻芯片的產能以及國際競爭力。
OMMIC公司于2006年 開 始 Si基 GaN 毫 米 波 功放的研究,并于2015年開發出100nm 制程下的Si基GaN 器件 制 備 工 藝 技 術 (D01GH), 在 30 GHz 時,Pout達3.3 W/mm,40GHz下的噪聲系數為 1.5dB,已接近 SiC 基 GaN 器件性能。緊接著在2016年公布了首個基于Si基 GaN 技術的高性能 T/R 芯片,能夠在37~43GHz頻率范圍內工作,40GHz下的總輸出功率達10 W,且 PAE達30%,實現了低噪放、功放以及開關的單片集成,可 較 好 地 應 用 于 雷 達、通信以及航空等領域。目前 OMMIC 公 司 已 具 備 全 球 領 先 的6英 寸 Si基 GaN 生 產 線, 并 且 制 程 推 進 到 60nm(D006GH),未來將繼續向下開發40nm 線寬的Si基GaN 制程,并向市場提供功放、低噪放、開關以及移相器完全集成,且兼容增強型和耗盡型器件的 T/R 芯片單片化方案,其 T/R 芯片的發展路線如圖7所示。可見 盡 管 Si基 GaN 器 件 在 性 能 方 面 與 SiC 基GaN 器件相比還存在差距,但 是 隨 著 材 料 生 長 技 術 和器件制備工藝的逐漸成熟,Si基 GaN 器件的截止頻率和功率密度 等 主 要 參 數 都 在 逐 步 提 高,未 來 達 到 與SiC基 GaN 相媲美的 性 能 指 日 可 待。同時微波毫米波頻段下基于 Si基 GaN 射 頻 器 件 的 產 品 也 陸續得以發布,展現出了巨大的競爭潛力,相 信 在 未 來 將 逐 步 占據更大的市場份額。
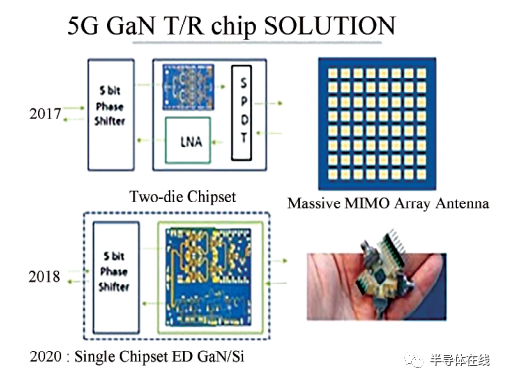
圖7 OMMIC公司發布的0.1μmSi基 GaN 收發芯片
2 Si基 GaN 射頻器件研制
圖8為 制 備 的 0.25 μm 和 0.4 μm 柵 長 的 Si基GaN 材料與器件結構示意圖,本 結 構 的 外 延 層 總 厚 度僅有2μm 左右,既能滿足典型28V 電壓下的正常射頻工作,又可確保材 料 具 備 較 低 的 熱 阻,同時對 GaN緩沖層進行一定濃度的 C 摻雜后 測 得 射 頻 損 耗(0.72dB/mm@4GHz)已接近SiC基 GaN 材料的結果(0.54dB/mm@4GHz),此 外 還 采 用 了 基 于 難 熔 W 金屬的疊層 V 型 柵 結 構,以 得 到 更 大 的 擊 穿 電 壓 和 更 高 的頻率。
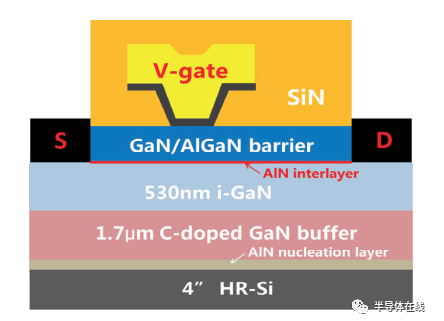
圖8 Si基 GaN 射頻材料與器件結構示意圖
經直流 測 試,0.25 μm 器 件 的 最 大 電 流 密 度(IDS.max)達0.97A/mm,峰值跨導(Gm.max)為0.29S/mm,0.4μm 器 件 的 IDS.max為 0.95 A/mm,Gm.max為0.26S/mm。此外按照IDS=1mA/mm 的標準,0.25μm 和0.4μm 器 件 的 擊 穿 電 壓 均高于80V,滿足28V 工作需求。頻率方面,經測試去嵌后0.4 μm 器件的fT和fmax分 別 為 27 GHz和 33 GHz;而 根 據 -20dB/dec斜率外推 |h21 |2和 MSG/MAG,得0.25μm器件的fT和fmax分別為35GHz和42GHz。
經 Load-Pull連續波功率測試,0.4 μm 器件在頻率為4GHz,電壓為28V 下 的 線 性 增 益 高 達17dB,PAE約為50%,Pout為4.5 W/mm。圖9顯示了0.25μm 器件在10GHz的測試結果,源 漏 偏 置 電 壓 為20V,線性增益為12.3dB,Pout為3.6 W/mm,PAE 約為45%。
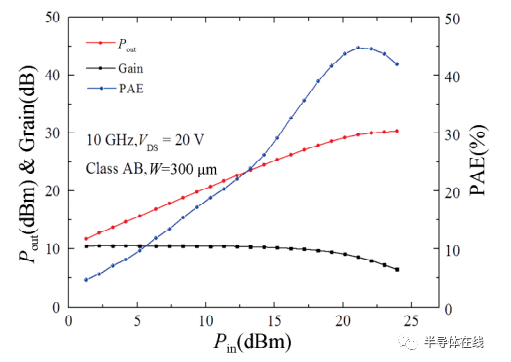
圖9 10GHz時Si基 GaN 器件的功率特性
此外,還將0.25 μm 工藝 Si基 GaN 射頻器件在10GHz左右的 功 率 特 性 分 別 與 國 外 研 究 成 果 進 行 對比,如表1所示,可見研制的Si基 GaN 射頻器件功率特性良好,達到國際先進水平。

表1 Si基 GaN 射頻器件在 X 波段下功率特性對比
3 總結與展望
通過對 Si基 GaN 射 頻 器 件 在 材 料 生 長、器件制備以及器件性能等方面的調研分析,介紹了改善Si基GaN 材料結構 缺 陷 并 優 化 器 件 制 備 流 程 的可靠途徑。材料方面,超 晶 格 緩 沖 層、背 勢 壘 層、C 摻 雜 GaN層、高質量成核層、GaN 帽 層 以 及 高 絕 緣 度 襯 底 等 結構設計,均有助于 改 善 晶 格 失 配、漏 電 及 射 頻 損 耗 等問題,而面向于射頻領域的 Si基 GaN 材料結構還應控制外延層厚度 以 獲 得 較 低 的 熱 阻;工藝方面,為最大降低成本,無 Au工藝是必要選擇,對于無 Au歐姆接觸工藝,結合二次外延 n+ -GaN 以及勢壘層刻槽等技術有助于提升表面 形 貌 并 降 低 接 觸 電 阻,同時結合PECVD、原位鈍化和 LPCVD 的復合 鈍 化 工 藝 在 對 表面的保護和漏電的抑制方面均表現出良好的效果。
低成本、批量化的生產Si基 GaN 射頻器件是5G通信、射頻源等應 用 實 現 的 重 要 保 障。盡管目前國內外各研究機構在 Si基 GaN 射 頻 材 料 外 延 與器件性能方面取得了一定進展,但是性能上與SiC襯底 GaN 相比仍然存在較大差距,而且可靠性 未 得 到 長 期 驗 證,離產業化尚存在較大距離。未來,通 過 提 高 外 延 材 料質量,開發兼容 CMOS的大尺寸制造工藝,提高Si基GaN 器件與電路芯片性能,降低生產成本,有望推動GaN 射頻技術在各類民生領域的普及應用。
