全球的智能手表市場仍看不到增長的邊界。這個消費電子新貴市場由蘋果公司所統治著,平均每3臺智能手表中就有一臺是Apple Watch。
Apple Watch不但引領了時尚的風潮,還帶動一項半導體制造工藝的進步。這就是將多個芯片封裝在一起的SiP(System-in-Package,系統級封裝)技術,其不但縮小了產品空間,還解決了困擾業界的異質芯片融合問題。
在摩爾定律逐漸式微的今天,SiP已經被看做是半導體技術突破的新希望。
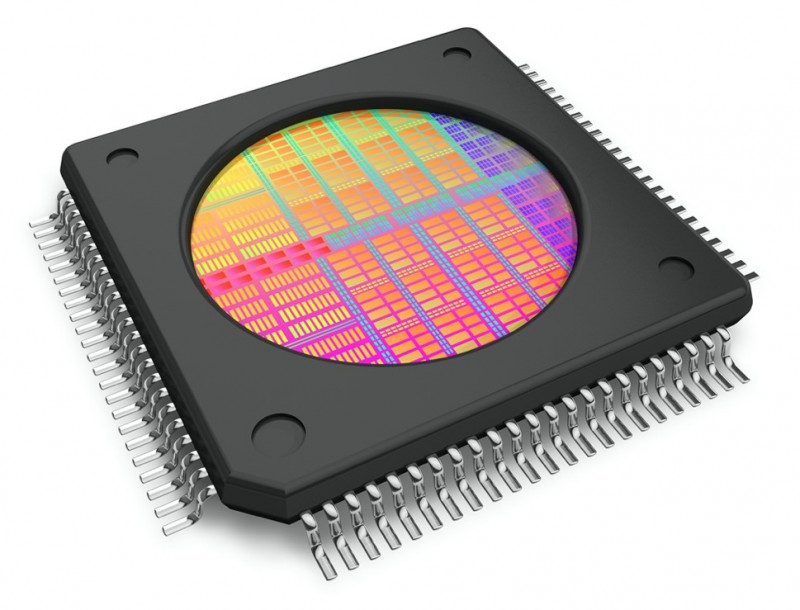
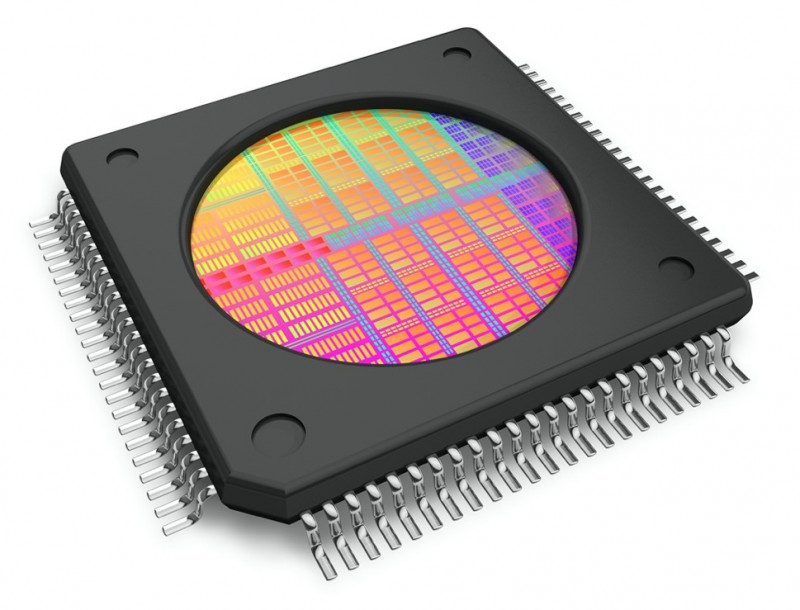
市場的厚愛
從第一代Apple Watch開始,蘋果就在S芯片中使用了SiP封裝,并沿用至今。以2019 年 9 月發布的第五代 Apple Watch S5為例,其普通版通過SiP方案將應用處理器(AP)、電源管理單元(PMU)、音頻芯片、調制解調器芯片以及充電芯片等芯片封裝在約700mm2大小 PCB 上,并在SiP模塊背面集合了慣性測量單元(IMU)和GPS前端模組;蜂窩板S5則在此基礎上增加了額外的射頻前端模組(RFFE) 和調制解調器芯片(Modem)。

其實,在更早一年發布的iPhone 6中,蘋果已經提前試水,為手機Wi-Fi模組使用了SiP封裝。
SiP技術發源已久,在蘋果介入之前并無很大的起色,市場接受程度不高。蘋果的入局成為轉折點,而三星等消費電子大廠紛紛跟進,終讓風向發生變化。
與芯片上使用的SoC技術相比,SiP系統集成度高,但研發周期反而短。因為SiP技術能減少芯片的重復封裝,降低布局與排線難度。所以,SiP技術非常適用于更新周期短的通訊及消費級產品市場。
異質集成一直是芯片界的大難題,但是SiP就能手到擒來。手機射頻系統的不同零部件往往采用不同材料和工藝,包括硅,硅鍺和砷化鎵以及其他無源元件。目前的技術還不能將這些不同工藝技術制造的零部件集成在一塊硅芯片上。但是SiP工藝卻可以應用表面貼裝技術SMT集成硅和砷化鎵芯片,還可以采用嵌入式無源元件,非常經濟有效地制成高性能RF系統。光電器件、MEMS等特殊工藝器件的微小化也將大量應用SiP工藝。
5G時代的智能手機更是能充分發揮SiP技術的特長。5G手機需要前向兼容2/3/4G通信制式,本身單臺設備所需射頻前端模組數量就將顯著提升。單部手機射頻半導體用量相比4G手機近乎翻倍增長。其中,接收/發射機濾波器從30個增加至75個,包括功率放大器、射頻開關、頻帶等都有至少翻倍以上的數量增長。器件數量的大幅增加將顯著提升結構復雜度,并提高封裝集成水平的要求。
運用了SiP技術,這些就可以迎刃而解。不但可以帶來更多的射頻前端SiP模組,還可以將毫米波天線與射頻前端形成AiP天線模組,甚至可以將基帶、數字、內存等更多零部件整合為更大的SiP模組。
高通已成功商業化Qualcomm System-in-Package(QSiP)模組就是一個典范。QSiP將應用處理器、電源管理、射頻前端、WiFi等連接芯片、音訊編解碼器和內存等400多個零部件放在一個模組中,為電池、攝像頭等功能提供了更大空間。
蘋果近年來還將SiP運用到Airpods Pro中,在滿足了性能要求的同時也釋放了寶貴的空間,使得SiP又進入到TWS耳機這個新熱點中。
對TWS耳機來說,SiP封裝工藝的3D堆疊特性,能夠讓耳機內部結構的各個組件基于人耳形狀布局,還可實現更多功能芯片和模組的有機結合,以及提升耳機舒適度、貼合度及穩定性。據歌爾聲學的相關報告數據,SiP工藝的應用可以將部分TWS耳機的器件整體尺寸減小50%。
此外,SiP工藝還能有效地保護IP。業內人士就表示,在傳統的PCBA上,很容易看到里面的芯片、器件型號,但TWS耳機的核心組件采用SiP封裝后,即使被破壞也很難看到所有細節。
不過,SiP封裝工藝也存在諸多難點,不僅涉及更復雜的布線、走線設計,還要克服信號干擾、散熱、續航力等問題,整體系統的設計難度大于傳統的TWS耳機封裝。所以,業內僅有蘋果AirPods Pro和三星Galaxy Buds Pro等少數產品采用。
未來5年, Wi-Fi路由器和物聯網也將在SiP市場快速增長,主要驅動因素是5G和傳感器。在電信和基礎設施領域,基站和服務器的復合年增長率都有望達到兩位數,其中基站的年復合增長率高達41%。這主要是因為5G基站需要通過倒裝芯片球柵陣列實現更多SiP集成。同時,服務器中的CPU、 xPU(小芯片、硅轉接板、扇出型)和FPGA也需要高端SiP。
蘋果近期發布的M1芯片正是因為采用SiP而戰斗力爆表,因此可以看出SiP還有非常巨大的潛力。
風向一邊倒
據統計,2019年SiP市場實現了134億美元的營收,復合年增長率達6%,2025年市場規模將實現188億美元。移動和消費類電子是SiP的最大市場(復合年增長率5%),緊隨其后的是電信和基礎設施(復合年增長率11%)和汽車市場(復合年增長率11%)。
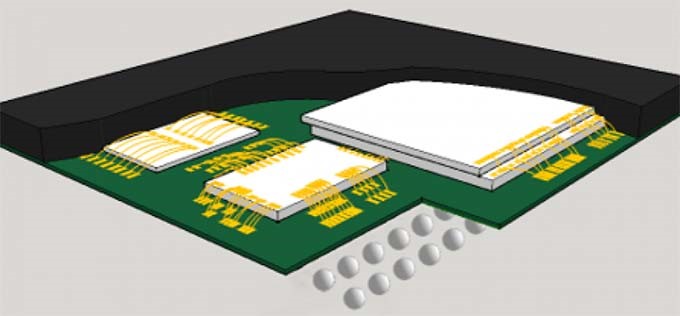
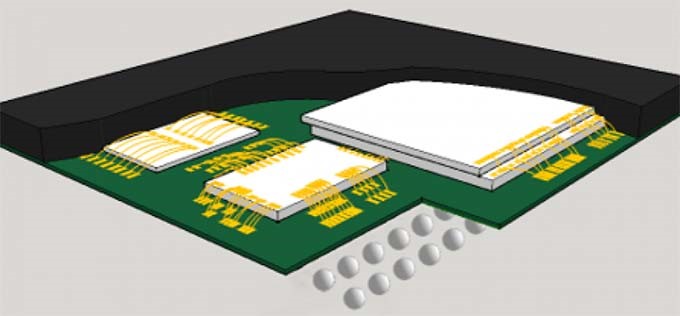
從市場格局來看,全球SiP市場中主要的廠商為日月光(環旭電子)、安靠、長電科技等,前五大廠商2019 年合計營收200億美元,行業集中度較高。其中日月光以絕對領先優勢居行業第一。在國內市場方面,日月光及環旭電子更是占據絕對優勢,領跑了SiP封裝行業。
環旭電子早在2012 年已經開始了無線通訊模組的技術投資,并在 2014 年開始進行 SiP 相關的技術投資,2014 年就對微小化系統模塊以及高傳輸高密度微型化無線通信模塊項目投資了12.23 億元人民幣。在2012-2019年的8年間,環旭電子對SiP及無線通訊相關項目共計投資22.65億元,逐步優化SiP技術、積累生產經驗,產業鏈已經達到成熟階段,產品良率在 99%以上。
大陸地區的封裝龍頭長電科技也在緊緊追趕。通過收購星科金朋,長電獲得了SiP技術,并可以與日月光相抗衡。星科金朋韓國廠已正式量產,主營業務為高端封裝測試產品及高階SiP產品封裝測試,專為重要戰略客戶供貨。據長電介紹,其目前重點發展幾種類型的先進封裝技術。首先就是系統級封裝(SiP),隨著5G的部署加快,這類封裝技術的應用范圍將越來越廣泛。其次是應用于Chiplet SiP的 2.5D/3D封裝,以及晶圓級封裝,并且利用晶圓級技術在射頻特性上的優勢推進扇出型(Fan-Out)封裝。
除了巨頭積極參與之外,現在做SiP也成了業界風潮,與兩年前的形勢簡直判若云泥。有行業資深投資專家表示:最近兩年新建的封裝廠很多,每個封裝廠都要打上SiP的旗號。根本上說是供需的天平滑向另一端。
以前要做一款SiP,最擔心沒有裸芯片,二擔心批量小沒有廠家接,但是現在情況完全不一樣了。
“Chiplet概念的提出代表著IC廠商逐漸以開放的態度提供裸芯片給客戶,大批新興的封測廠商也樂意接收小批量多種類的SiP封測業務。”一位業內人士這樣表示。
而據上述行業資深投資專家分析,風向改變還有三個重要原因:首先是封裝小型化的需求增加,SiP需求更多;第二是能做SiP的廠商越來越多;第三是因為出貨的壓力,愿意提供Wafer的企業也越來越多。“這個趨勢會越來越明顯。現在的芯片廠為了招攬客戶,甚至會主動提供Wafer。”他補充道。
在封裝業全體倒向SiP的同時,SiP也在改變電子組裝業的格局,像歌爾聲學、立訊精密等大廠因為進入蘋果供應鏈而很早切入這個領域,并逐漸發展出自己的技術路線。
